 главная · контакты · книги главная · контакты · книги
|
Универсальный электронный микроскоп УЭМВ-100В
А. ТЕХНИЧЕСКОЕ ОПИСАНИЕ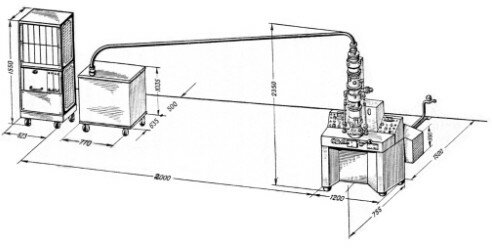
I. НАЗНАЧЕНИЕУниверсальный электронный микроскоп УЭМВ-100В (рис.1) предназначен для визуального и фотографического исследования объектов. Прибор позволяет:
Укомплектованный по отдельному договору дополнительными приставками прибор позволяет:
Электронно-оптическая система прибора снабжена двумя конденсорными, объективной, промежуточной и проекционной линзами, обеспечивающими увеличение прибора от 300 до 200.000 крат. Промежуточная и проекционная линзы обеспечивают плавное изменение увеличения при постоянном поле изображения; Объектив снабжен стигматором, облегчающим получение высоких разрешений. Фотографирование изображений при всех видах исследований производится на фотопластинки. Микроскоп должен эксплуатироваться в отапливаемом и вентилируемом помещении при температуре 25 ±10°С и относительной влажности 65 ±15% при 20°С. Вблизи помещения с прибором недопустимо наличие оборудования, создающего вибрации. Желательно устанавливать прибор на 1-ом этаже здания без подвала. В помещении, где установлен прибор, напряженность переменного магнитного поля не должна превышать 1.10-3 эрстед. [1 Эрстед ≈ 80 А/м] 2. ТЕХНИЧЕСКИЕ ДАННЫЕРазрешаемое расстояние, Å ... 8 Электронное увеличение, крат ... 300 + 200000 Рабочий вакуум, мм рт.ст.... 1 ÷ 2.10-4 Расход воды для охлаждения, л/мин... 5 Количество фотопластин в фотомагазине .. 24 Размер фотопластин, см... 6,5 х 9 Ускоряющее напряжение, кв .... 50, 75, 100 Нестабильность ускоряющего напряжения, 1/мин..... 1.10-5 Пульсации ускоряющего напряжения, мв ... 250 Ток первый конденсорной линзы, ма .. 55 ÷ 235 Ток второй конденсорной линзы, ма .. 55 ÷ 210 Ток объективной линзы, ма .... 120 ÷ 450 Ток промежуточной линзы, ма .... 50 ÷ 450 Ток проекционной линзы, ма... 200 ÷ 450 Нестабильность тока первой конденсорной: линзы, 1/мин..... 1.10-4 Нестабильность тока второй конденсорной линзы, 1/мин ..... 5.10-5 Нестабильность тока объективной линзы, 1/мин..... 5.10-6 Напряжение питающей сети, в.... 380/220 или 220/127 Частота, гц .... 50 Потребляемая мощность, ква ... 4 Нестабильность токов промежуточной и проекционной линз, 1/мин...1.10-5 Нестабильность тока стигматорных и юстировочных катушек, 1/30 мин... ±1.10-4 Пульсации напряжения источников питания линз, стигматоров и юстировочных катушек, мв ......10 Точность измерения токов линз, %... 1,5 Напряжение на верхней паре отклоняющих пластин, кв ..... ±1,35 Напряжение на нижней паре отклоняющих пластин, кв......±2 Нестабильность напряжения на отклоняющих пластинах, мв.... ±800 Пульсации напряжения на отклоняющих пластинах, мв ....10 Предел срабатывания вакуумной блокировки, мм рт.ст....(0,7 ÷ 1,3).10-3 Габариты микроскопа и вес: Стенд микроскопа с колонной, высота, мм 2200; Занимаемая площадь в плане, мм 1500 х 1200; Вес, кг 500 Шкаф питающего устройства: высота, мм ......1550; Занимаемая площадь в плане, мм .... 620 х 665; Вес, кг ......250 Высоковольтный выпрямитель: высота, мм .....1035; Занимаемая площадь в плане, мм ... 635 х 770; Вес, кг ......300 Общий вес прибора, кг ...1050 3. СОСТАВ ИЗДЕЛИЯВ комплект микроскопа входит:
Кроме того, по договору с заказчиком поставляются дополнительно:
4. ПРИНЦИП РАБОТЫ И КОНСТРУКЦИЯЭлектронный микроскоп состоит из колонны, стенда, вакуумной системы, пультов управления и блоков системы питания. Конструктивно колонна, вакуумная система и пульты управления расположены на столе стенда микроскопа. 4.1. Принцип работы прибораВозможности световых микроскопов ограничены волновой природой света. При оптимальных условиях световые микроскопы позволяют наблюдать объекты, вследствие явления диффракции, не менее 1/3 длины световой волны. Дальнейшее проникновение в мир малых величин стало возможным лишь при использовании в микроскопии электронных лучей, обладающих более короткими длинами волн, чем длины волн световых лучей. Приборы, в которых получают увеличенное изображение о помощью электронных пучков, называются электронными микроскопами. Пучку электронов, движущемуся в вакууме с постоянной скоростью, обусловленной прохождением электронами ускоряющего электрического поля в U вольт, соответствует волновой процесс с длиной волны λ, определяемый выражением: λ = √(150/U) ⋅ 10-8 = 12,25 / √U ⋅ Å, где: U - ускоряющее напряжение в вольтах. В электронном микроскопе роль линз играют неоднородные поля, обладающие вращательной симметрией. В зависимости от электронно-оптической системы, используемой в электронных микроскопах, последние разделяются соответственно на электронные микроскопы с электростатической оптикой и микроскопы с магнитной оптикой. Качество изображения, получаемое при использовании магнитной оптики, несколько выше, благодаря чему магнитные электронные микроскопы получили более широкое распространение. Электронная микроскопия с успехом применяется для изучения биологических объектов, вирусов, катализаторов, коллоидных растворов, красителей, силикатов, тонких металлических слоев, получаемых испарением в вакууме или катодным распылением, и т.д. В универсальном микроскопе УЭМВ-100В используется электромагнитная оптика, позволяющая получать на экране и фотографировать изображение объекта при увеличениях от 300 до 200000 крат. 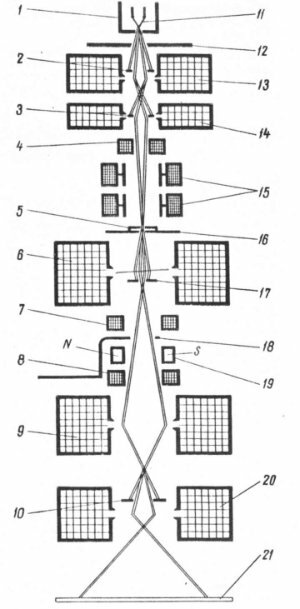
Рис. 2. ОПТИЧЕСКАЯ СХЕМА МИКРОСКОПА: 1 - фокусирующий электрод; 2 - диафрагма первого конденсора; 3 - диафрагма второго конденсора; 4 - стигматор второго конденсора; 5 - объект; 6 - объективная линза; 7 - стигматор объективной линзы; 8 - стигматор промежуточной линзы; 9 - промежуточная линза; 10 - диафрагма поля зрения; 11 - катод; 12 - анод; 13 - первый конденсор; 14 - второй конденсор; 15 - призмы для юстировки осветителя; 16 - столик объектов; 17 - апертурная диафрагма; 18 - селекторная диафрагма; 19 - механизм юстировки объектива; 20 - проекционная линза; 21 - экран. Принципиальная оптическая схема УЭМВ-100В (рис.2) аналогична схеме светового микроскопа, в которой все световые оптические элементы заменены соответствующими электрическими элементами: источник света заменяется источником электронов, а стеклянные линзы — линзами электромагнитными. Источником пучка электронов является электронная пушка, состоящая из катода, фокусирующего электрода и анода. Электронная пушка создает пучок электронов, который с помощью конденсорных линз формируется и направляется на исследуемый объект. Пучок электронов, пройдя сквозь объект попадает в объективную линзу, которая формирует увеличенное изображение объекта. После объективной линзы электроны попадают в промежуточную линзу, которая предназначена для плавного изменения увеличения микроскопа и получения диффракции с участков исследуемых образцов (электронной микродиффракции). Следующая линза (проекционная) создает конечное увеличенное изображение объектов на флюоресцирующем экране. Увеличение конечного изображения на экране определяется как произведение увеличений, даваемых объективной, промежуточной и проекционной линзами. Известно, что теоретический предел разрешающей способности электронного микроскопа ограничивается сферической аберрацией и дифракционными явлениями. Но практически на разрешение прибора относительно большее влияние оказывает астигматизм, хроматическая аберрация, а также электрические и механические помехи. Для работы с высоким разрешением необходимо тщательно юстировать прибор, снижать до минимума астигматизм объектива с помощью стигматора, следить за стабильной работой блоков электропитания, устранять вибрации и прочие помехи. Исследуемый объект также должен быть приготовлен с учетом требований, соблюдение которых необходимо при работе с высоким разрешением (малый разброс электронов по скоростям, вызываемый объектом, высокий контраст, устойчивость к пучку и т.п.). Юстировка электронного микроскопа преследует две цели: получение максимальной яркости изображения и создания условий, при которых сферическая и хроматическая аберрация были бы минимальными. В качестве источника электронов в микроскопе используется V-образный вольфрамовый термокатод 1 (рис.3). 
Рис.3: 1 — катод, 2 — фокусирующий электрод, 3 — анод. При нагревании его до температуры порядка 2900°С в результате термоэмиссии возникают свободные электроны, ускоряемые затем электростатическим полем. Электростатическое поле создается между фокусирующим электродом 2 (цилиндром Венельта) и анодом 3. Между катодом и фокусирующим электродом приложено отрицательное напряжение (напряжение смещения), величина которого может плавно меняться. Катод располагается внутри фокусирующего электрода, благодаря чему достигается хорошее управление пучком электронов. Осветительная система характеризуется электронной яркостью: R = jβ / πɑβ², где jβ — плотность тока электронного пучка на объекте (а/см²); ɑβ — апертура осветителя (т.е. половина угла, при вершине конуса, образованного проходящими лучами). На практике апертура осветителя задается осветительной диафрагмой конденсора либо током 1-го конденсора. Яркость изображения зависит от плотности тока на экране. Если для получения достаточной яркости конечного изображения требуется плотность тока пучка, падающего на экран jэ, то плотность тока на объекте будет: jβ = jэ ⋅ M², где: М — полное увеличение микроскопа. Плотность электронного пучка на объекте принципиально ограничивается следующими факторами:
Величина ускоряющего напряжения фиксирована для данного микроскопа. Повысить плотность тока пучка можно за счет повышения удельной эмиссии катода. Повышение удельной эмиссии вольфрамовых катодов возможно только за счет повышения температуры накала. Однако, при этом сокращается их срок службы. Что касается величины угла схождения пучка (апертуры осветителя), то она связана с разрешающей способностью электронного микроскопа. Плотность тока пучка зависит также от расположения катода относительно фокусирующего электрода (рис.3). С уменьшением плотность тока увеличивается. Можно увеличить плотность тока, регулируя напряжение смещения. При этом плотность тока достигает максимальной величины только при некотором оптимальном напряжении смещения. Это объясняется влиянием хроматических аберраций на пучок, возникающих из-за неоднородного распределения поля у острия катода. 
Рис. 4. Двухлинзовый конденсор При очень больших и малых напряжениях смещения образуются расходящиеся электронные пучки. Только в оптимальном случае электроны, уходящие с катода, попадают в однородное поле и поэтому образуют параллельный пучок. Для того, чтобы иметь возможность в широких пределах изменять условия освещения объекта, в осветительную систему вводят конденсор. Используя однолинзовую конденсорную систему получают диаметр пучка, сфокусированного на объекте приблизительно 50 мк. При больших увеличениях необходимо облучать объект током большой плотности, что вызывает перегрев объекта. Снизить температуру объекта можно, уменьшая облучаемую область до нескольких микрон в диаметре. Для этих целей используют двухлинзовый конденсор. С двухлинзовым конденсором можно получить изображение пятна на объекте диаметром приблизительно 1 мк, значительно большей интенсивности. Двухлинзовый конденсор состоит из первой — короткофокусной линзы, которая уменьшает изображение минимального сечения пучка, и второй — длиннофокусной конденсорной линзы, которая переносит изображение, образуемое первой конденсорной линзой, в плоскость объекта, незначительно его увеличивая (см.рис 4). При этом сферическая аберрация и приосевой астигматизм первой конденсорной линзы столь малы, что ими можно пренебречь. А это значит, что плотность тока плоскости изображения наименьшего сечения пучка остается постоянной. Напротив, сферическая аберрация и приосевой астигматизм второй конденсорной линзы могут существенно влиять на плотность тока на объекте jβ и на диаметр освещенного участка объекта 2rβ. Сферическая аберрация так искажает пучок, что в плоскости изображения вместо точки получается кружок рассеяния. Радиус кружка рассеяния пропорционален кубу апертуры. Приосевой астигматизм — это аберрация, которая возникает из-за нарушения вращательной симметрии фокусирующего поля. Приосевой астигматизм приводит к тому, что любая точка, расположенная на оси, изображается не в виде точки, расположенной на оси, а в виде эллипса. Это приводит к уменьшению плотности тока и потере яркости изооражения. Для устранения приосевого астигматизма во втором конденсоре имеется стигматор. С двухлинзовым конденсором рекомендуется работать прежде всего в тех случаях, когда исследуемый объект легко разрушается под действием пучка. Необходимо подчеркнуть, что при использовании двухлинзового конденсора качество изооражения также повышается. Это имеет место как в случае наблюдения изображения объекта, так и в случае получения диффракционных и микродиффракционных спектров. На практике удобно выбирать диаметр пучка таким, чтобы на конечном экране при сфокусированном втором конденсоре и нужном увеличении освещенная площадь объекта как раз заполняла бы экран. Таким образом, ток первого конденсора можно подобрать в соответствии с общим увеличением. Для получения оптимальных условий освещения в микроскопе предусматриваются механизмы юстировки элементов осветительной системы относительно оси объектива. Эти юстировочные механизмы позволяют перемещать освещающий пучок в плоскости, перпендикулярной оси объектива. Кроме того, предусмотрена возможность юстировки катода с фокусирующим электродом относительно анода. Эти юстировки обеспечивают получение максимальной яркости на объекте. Наряду с этим в микроскопе имеется механизм наклона осветительной системы относительно оси объектива. В отличие от предыдущих юстировок он не влияет на яркость изображения, но от его правильной настройки зависит разрешающая способность микроскопа. Регулируя наклон осветительной системы, необходимо добиться совпадения оси освещающего пучка с осью объектива. Если это сделано неточно и существует некоторый угол между осями пучка и объектива, сферическая аберрация объектива возрастает по закону: δθ = C[(θ+d)³-(θ-d)³], где: δθ максимальный диаметр аберрационной фигуры, C - коэффициент сферической аберрации, d - действующая апертура объектива. Если θ = 0 то δθ = 2cd³ Для угла наклона θ равного, например, апертурному углу ɑ, δcp = 4δθ, т.е. сферическая аберрация возрастает в 4 раза, а это резко ухудшает разрешающую способность микроскопа. 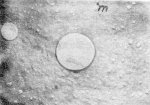
Методика юстировки наклона осветительной системы состоит в следующем. В качестве тест-объекта используется пленка с большим числом отверстий. Объект обычно наблюдается при небольшом увеличении порядка 3 т 6 тысяч крат. Соответственно средний диаметр отверстий составляет 2 т 0,5 мк. Отверстия наблюдаются при большой яркости. Диафрагма осветителя должна быть убрана. Удаляется также апертурная диафрагма из объектива. На краях отверстий наблюдаются каемки. Они расположены несимметрично относительно отверстий. Однако, вся картина имеет явно выраженный центр симметрии (точка m, рис.5). Расположение каемок хорошо видно вокруг отверстий в тонких коллодиевых пленках, укрепленных углеводородным слоем. 
Установлено, что в области центра симметрии (точка нулевой комы) сферическая аберрация минимальна. Изменяя наклон осветительной системы, можно вывести центр симметрии на средину экрана (рис.6). В этом случае для наблюдаемой в микроскопе области объекта угол наклона осветителя оказывается разным нулю. Микроскоп работает с минимальной сферической аберрацией. В случае изменения ускоряющего напряжения все точки объекта совершают движение по спиралям относительно неподвижной точки, получившей название Вольтова центра. Область изображения, содержащая Вольтов центр, обладает минимальной хроматической аберрацией. Хроматическая аберрация вызывается разбросом по скоростям электронов, формирующих изображение. Разброс скоростей происходит вследствие изменения скорости электронов при прохождении сквозь объект и подложку объекта, вследствие разной начальной скорости электронов, выходящих из катода, а также вследствие колебаний ускоряющего напряжения за время наблюдения. В результате точка объекта отображается в плоскости изображения в кружок радиуса dr, называемый кружком хроматического рассеяния. Обычно Вольтов центр и точка нулевой комы не совпадают. Поэтому в области минимальной сферической аберрации хроматическая не минимальна и наоборот. Несовпадение точек нулевой комы и Вольтова центра происходит главным образом из-за неоднородности магнитного материала полюсного наконечника объектива.  
Если необходимо, чтобы в результате юстировки электронный микроскоп работал с минимальной хроматической аберрацией, то найти Вольтов центр можно, производя переключение высокого напряжения с одной ступени на другую. В момент переключения изображение разворачивается по спирали вокруг Вольтова центра. Вольтов центр микроскопа можно определить еще путем наложения переменной составляющей на ускоряющее напряжение. Такой способ нахождения Вольтова центра предусмотрен в микроскопе УЭМВ-100В. Регулируя наклон осветительной системы, Вольтов центр выводят на центр экрана (рис7 и 8). Разрешающую способность микроскопа часто ограничивает приосевой астигматизм объективной линзы. При наличии приосевого астигматизма линза обладает различной преломляющей силой в различных радиальных плоскостях. Существуют две взаимно-перпендикулярные радиальные плоскости, в одной из которых фокусное расстояние максимально, а в другой — минимально. Приосевой астигматизм оценивают так называемой астигматической разностью фокусных расстояний. При этом для получения высокого разрешения астигматическая разность фокусных расстояний должна быть минимальной. Основными причинами возникновения астигматизма являются отступление геометрической формы полюсных наконечников от осевой симметрии в результате неточного изготовления и магнитной неоднородности материала полюсного наконечника. Влияние этих причин в процессе эксплуатации микроскопа остается неизменным. На астигматизм объектива влияют также загрязнения полюсного наконечника, которые образуются под действием электронного пучка, загрязнения апертурной диафрагмы, децентровка апертурной диафрагмы и некоторые другие факторы. Влияние этих факторов меняется со временем. Метод обнаружения астигматизма основан на явлении диффракции на краю полупрозрачного экрана, расположенного на пути электронного пучка. В плоскости, расположенной за экраном на некотором расстоянии от него, вместо резкой тени наблюдаются диффракционные полосы Френеля. Механизм образования полос состоит в следующем. На краю экрана при прохождении сферической волны возникает цилиндрическая волна. В результате интерференции цилиндрической и сферической волн в любой плоскости, отличной от плоскости экрана, образуются чередующиеся светлые и темные полосы, т.е. минимумы и максимумы интенсивности. Для обнаружения астигматизма в качестве объекта используются пленки с отверстиями либо тонкие пленки, на которые наносят частицы сажи. Если объектив сфокусировать на какую-ниоудь плоскость, не совпадающую с плоскостью пленки, то вместо четких краев отверстия можно увидеть диффракционную картину. В обычных условиях наблюдается первый максимум. Этого вполне достаточно для обнаружения астигматизма. Так как вследствие астигматизма фокусное расстояние меняется при переходе от одной радиальной плоскости к другой, на экране наблюдается диффракционная картина, соответствующая различным расстояниям от объекта. Поэтому ширина диффракционной полосы меняется (рис.9). На этом рисунке стрелками показаны точки максимальной и минимальной ширины диффракционной каймы. 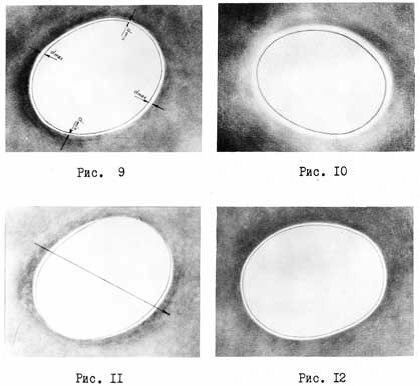
Чтобы точнее устранить астигматизм, необходимо работать как можно ближе к фокусу. В противном случае трудно наблюдать и корректировать астигматизм. Это показано на рис.10, из которого видно, что с ростом дефокусировки дифракционная кайма приобретает почти симметричную форму. Коррекция астигматизма в микроскопе производится при помощи стигматора объектива. Стигматор представляет собой регулируемую цилиндрическую линзу, оптическая сила и ориентация которой регулируется оператором. Пользуясь описанным методом обнаружения астигматизма, следует так подобрать ориентацию и величину астигматизма, вносимого стигматором, чтобы наступила полная компенсация астигматизма объектива. На рис.11 приведена фотография, полученная до компенсации астигматизма. После компенсации астигматизма получена фотография, рис.12. Величину исходного астигматизма можно оценить по току стигматора, при котором наступает компенсация. Величина астигматизма со временем меняется вследствие образования углеводородных пленок и других загрязнений. Следовательно, по току стигматора можно судить о состоянии прибора. Электронный микроскоп позволяет производить глубокий анализ тонкого строения вещества. Электроннографический анализ по своей точности и широте практических применений не уступает рентгенографическому анализу. Конструкция электронного микроскопа предусматривает возможность получения диффракции электронов от тех же объектов, которые исследуются в электронном микроскопе. При прохождении узкого монохроматического пучка электронов через тонкий кристаллический объект на экране, расположенном на некотором расстоянии от объекта, возникает диффракционная картина. Диаметр пучка можно регулировать конденсорными линзами и осветительными диафрагмами. В этом случае электронные линзы используются только для фокусировки электронного пучка, непосредственного участия в формировании диффракционного изображения линзы не принимают. Электронный микроскоп приспособлен также для локального структурного анализа. При этом в некоторых случаях удается получить электронограммы с участков порядка 1 мк. Метод локального исследования структуры вещества, получивший название микродиффракции, дает возможность проводить идентификацию кристаллов, наблюдаемых в микроскопе, определять габитус кристаллов, межплоскостные расстояния и ориентацию кристаллических осей, а также получать важные сведения о механизме роста кристаллов, о полиморфных и других превращениях кристаллов. Для получения микродиффракционных картин используется вся оптическая система электронного микроскопа (рис.2). Применение оптической системы для формирования диффракционных картин дает большие преимущества. Но вместе с тем, оно вносит известные трудности в расшифровку электронограмм, так как оптика вызывает некоторые искажения электронограммы и снижает ее разрешение. При прохождении электронов через объект в задней фокальной плоскости объективной линзы формируется первичное диффракционное изображение объекта. Промежуточной линзой оно переносится в предметную плоскость проекционной линзы. Проекционная линза на конечном экране дает увеличенную диффракционную картину объекта. Для выбора участка объекта в плоскости изображения объектива находится специальная селекторная подвижная диафрагма. Селекторная диафрагма дает возможность получать электронограммы с участков объекта диаметром в несколько микрон. Необходимо помнить, что вследствие влияния сферической аберрации объективной линзы и неточного совмещения плоскости изображения объектива с плоскостью селекторной диафрагмы на электронограмме появляются рефлексы от соседних участков. Этот эффект не позволяет выбирать участок объекта при микродиффракции диаметром меньше 1 мк. При изучении ряда малоконтрастных объектов (тонкие слои, биологические объекты и др.) можно заметно повысить контраст при наблюдении изображения в темном поле. Особенно значительное повышение контраста достигается при наблюдении в темном поле структуры кристаллических объектов, когда в формировании изображения участвуют электроны, отраженные от кристаллических плоскостей. Так как в формировании изображения в случае темного поля принимают участие только рассеянные электроны, входящие в поле линзы под углом, то влияние аберраций значительно возрастает и вследствие этого разрешение темнопольных фотографий ниже, чем светлопольных. С помощью электронного микроскопа можно получать хорошие стереоскопические снимки, так как глубина резкости его линз очень большая. Большая глубина резкости электронного микроскопа определяется малой апертурой, применяемой в нем: T = δ/ɑ, где: T - глубина резкости δ - разрешение, ɑ - апертура.
|
Комментарии
| © 2008-2023, Laboratorium.dp.ua — документация на лабораторное оборудование. | © Dr. Andy |
Авторство
Адрес: 49005, Днепропетровск, ул. Севастопольская, 17 (морфологический корпус ДГМА).
 контактная информация, написать сообщение
контактная информация, написать сообщение

|
